華南檢測技術:深入解析芯片IV曲線與SAT測試案例
一、芯片案例背景:芯片檢測的挑戰與需求
在最近的一個項目中,我們收到了客戶送來的1Pc芯片樣品,要求進行I-V測試、X-ray掃描、SAT掃描。這些測試對于評估芯片的性能和可靠性至關重要。我們的專業團隊立即著手,以確保為客戶提供準確的芯片檢測結果。

二、芯片分析過程:深入的芯片檢測技術
1. 外觀檢查:
首先,我們使用光學顯微鏡對芯片正表面進行了細致的外觀檢查。結果顯示芯片正表面存在孔洞,疑似燒傷痕跡,這可能是由于電過載(EOS)造成的損傷。
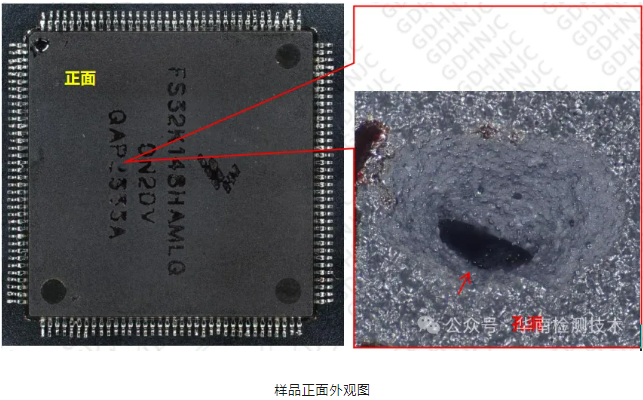
2. X-Ray測試:
進一步的X-Ray射線檢查揭示了芯片內部鍵合線存在斷線形貌,這進一步證實了EOS損傷的假設。X-Ray測試是芯片檢測中不可或缺的一環,它能夠透視芯片內部結構,發現潛在的物理損傷。
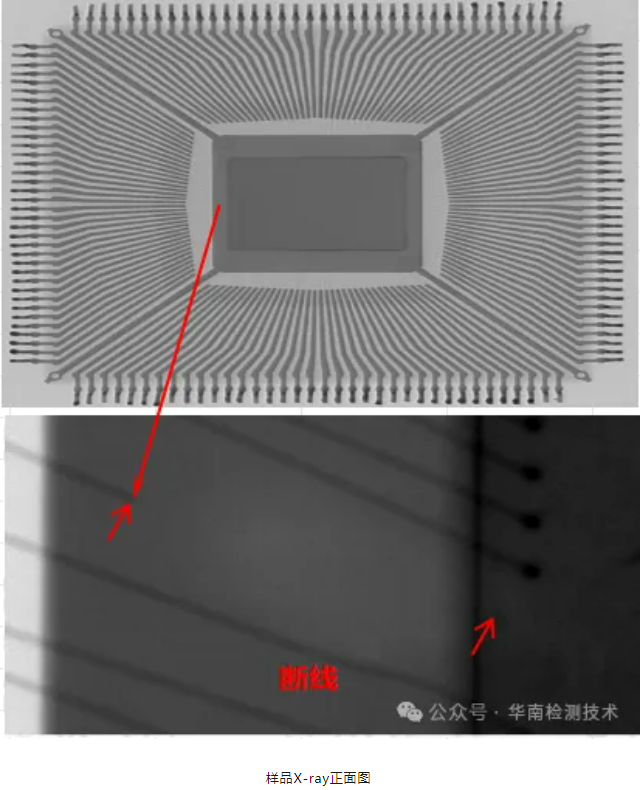
3. SAT檢查:
SAT(超聲波掃描顯微鏡)檢查進一步確認了我們的發現。檢查顯示芯片表面及引線框表面均有明顯分層形貌,這是EOS損傷的直接證據。SAT檢查以其高分辨率和非破壞性特點,在芯片檢測中扮演著關鍵角色。
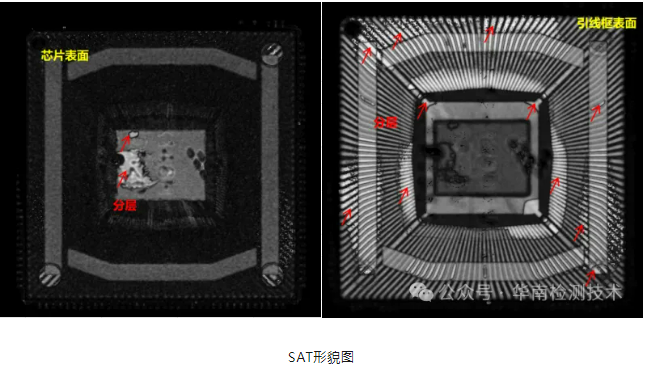
4. 電性能測試:
最后,我們進行了I-V測試,以評估芯片的電性能。測試曲線顯示14引腳為開路,而其他引腳測試則顯示出明顯的曲線。這一結果直接指向了芯片的電性能問題,進一步證實了EOS損傷的影響。
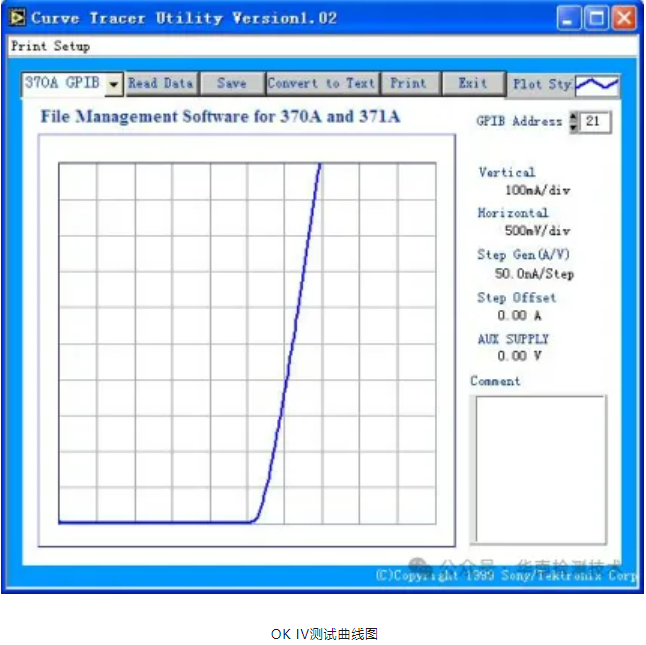

三、芯片分析結果:芯片檢測的結論
綜合外觀檢查、X-ray檢測、SAT掃描檢測及I-V曲線測試的結果,我們推斷該芯片在使用過程中存在EOS,導致鍵合引線損壞而失效。這一結論為客戶的后續行動提供了明確的指導,幫助他們理解芯片失效的原因,并采取相應的措施。
華南檢測:http://www.gdkanglide.cn/websiteMap

廣東省華南檢測技術有限公司專注于失效分析、材料分析、成分分析、可靠性測試、配方分析等檢測分析服務,擁有CMA和CNAS資質。公司坐落于東莞大嶺山鎮,鄰近松山湖高新技術產業開發區,配備了行業內先進的測試設備和專業技術團隊。華南檢測技術有限公司的客戶涵蓋多個行業,包括半導體、電子元件、納米材料、通信、新能源、汽車、航空航天、教育和科研等領域。



 熱門關鍵詞:
熱門關鍵詞:




