元素分析是什么?
要了解元素分析,首先需要明白X射線的產生,它是當電子射入物質后,從物質表面會發射出各種電子、光子及X射線等電磁波。如圖49所示,由于入射電子的作用,內層電子處于激發態,外層電子向內躍遷填補有空位的軌道時,會產生等同于能量差的X射線,這就是特征X射線。 由于X射線具有元素特有的能量(波長),通過對X射線的檢測,能夠進行元素分析。K層的電子被激發釋放出的特征X射線被稱為K線系,L層、M層被分別稱為L線系、M線系。越是重元素特征X射線的能量越大,這是因為激發時需要高能入射電子。另一方面,入射電子被原子核減速時產生的X射線被稱為連續X射線或者軔致輻射X射線。

特征X射線的產生原理
X射線分光譜儀
● EDS的分光原理
能譜儀(Energy Dispersive X-ray Spectrometer:EDS)是通過測試X射線的能量分析特征X射線譜的裝置。如圖50所示X射線進入半導體檢測器后,會產生一定數目的、相當于X射線能量的電子-空穴對,測試其數量(電流)就可以知道X射線的能量,為了減少檢測器的電氣噪音,需用液氮等進行冷卻,從B~U的X射線能夠同時測試是EDS的特征。圖51是通過EDS獲得的譜圖,橫軸為X射線的能量值,縱軸為X射線的計數率。

EDS半導體檢測器的結構 EDS譜圖實例
●WDS的分光原理
波譜儀(Wavelength Dispersive X-ray Spectrometer :WDS)是通過測試X射線的波長分析特征X射線譜的裝置。如圖52所示那樣,通過分光晶體利用X射線的衍射現象來測試波長,在被稱為羅蘭圓的一定半徑的圓上移動分光晶體和檢測器,為了覆蓋全波長范圍,需要配備若干多個分光晶體和驅動機構,因此獲取X射線譜圖的時間較長。

WDS的分光原理
EDS和WDS的不同見表2所示。EDS的特長是用很小的探針電流就可以測試,在比較短的時間內能獲得譜圖,而WDS具有能量分辨率(波長分辨率)高,能夠檢測痕量元素的特點。SEM大多都裝有EDS,而WDS一般作為以元素分析主要目的的電子探針顯微分析儀(Electron Probe Microanalyzer:EPMA)的分光器而被使用。

表2 EDS和WDS的特征
定性分析根據X射線的譜圖,能夠進行確定電子束照射的區域中存在哪些元素的定性分析。分析模式有三種:獲去電子束照射區域譜圖的點分析,顯示感興趣元素在指定的線上如何分布的線分析,以及顯示感興趣元素的二維分布的面分析,面分析有時也稱面分布。點分析是對樣品上的一點(參照分析區域)進行定性分析,如果是對有一定范圍的區域(不是一個點)進行分析時,定性分析是在電子探針在掃描這一區域(觀察圖像)的同時進行的,檢出限(能檢測出多少微量的元素)根據元素而不同,EDS一般為數千ppm。
X射線面分析只關注特定能量的特征X射線,將電子探針在樣品上掃描的分析為X射線面分析,它能夠知道樣品中元素的分布。但需要注意的是,如果P/B極低(與背底強度相比峰強度很小),X射線圖顯示的不是欲測元素的分布而是連續X射線的分布;此外當欲測元素的特征X射線的能量與其它元素很接近、它們的能量差等于分光譜儀的能量分辨率時,X射線圖有時會顯示其它元素的分布,圖53是X射線面分析的實例,與二次電子、背散射電子相比,特征X射線的強度較弱,因此獲取圖像需花費較長的時間。
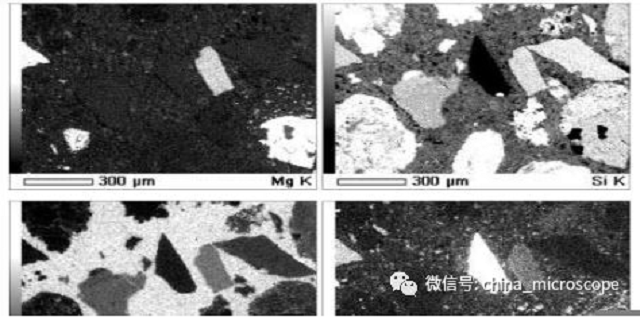
圖53 X射線面分析的實例樣品:混凝土碎片
如后面所述X射線面分析的分辨率取決于分析區域,如果樣品表面附近局部存在著特定的元素時,即使顆粒小于分析區域,也能夠識別。
在樣品上用電子探針進行掃描的同時,逐點進行定量分析的方法叫做定量面分析。這一方法與單純的X射線面分布不同,即使P/B比較低也能夠知道元素的準確分布。
分析區域射入樣品的電子在失去能量的同時在樣品中發生擴散,在這個過程中會激發X射線。因此X射線的產生區域具有一定的范圍,在正常的工作條件下為納米 微米尺寸。需要注意的是,在SEM圖像中想要分析數nm~數十nm的顆粒,而實際的分析區域會變大很多。降低加速電圧雖然可以縮小X射線的產生區域,但加速電圧(電子能量)必須高于被激發的特征X射線能量,因此降低加速電圧是有極限的。要進一步縮小分析區域,可以采用制備薄膜樣品的方法。例如,厚度為100nm左右的樣品在30kV的電壓下進行分析的話,很多元素可以獲得100nm以下的分析區域。
定量分析由于特征X射線的強度與對應元素的濃度成正比例,因而能夠進行定量分析。只要將已知濃度的標準樣品的X射線強度與未知樣品的X射線強度進行比較就能夠知道未知樣品的元素濃度。但是,樣品中產生的X射線在射入真空前有可能被樣品吸收或激發其它元素,因此需要對其進行定量校正,現在使用的EDS和WDS能夠簡單地進行校正計算,但校正進行的前提必須是X射線產生區域中元素的分布是相同,樣品表面是平坦的,電子探針是垂直入射的等。實際上SEM的樣品很多都沒有滿足這一前提條件,因此,應該意識到實際上可能會有不小的誤差。
非導電性樣品的分析與一般的SEM觀察一樣,分析非導電性樣品需要進行金屬鍍膜,與SEM觀察不同需要注意的是,不能鍍制樣品中可能含有的、相同元素的金屬。此外,以檢測輕元素為目的時,鍍上重金屬的厚膜可能會阻礙輕元素X射線的發射,因此鍍膜必須盡量以薄為好。 如果對非導電性樣品不鍍膜直接進行分析,由于荷電效應在低加速電圧下進行分析的話,會出現激發能高的特征X射線檢測不出來,定量分析的精度下降等現象。 此外進行線分析、X射線面分布時,有時還會發生電子探針位置漂移的問題。使用低真空SEM(Low Vacuum SEM,簡稱LV SEM)對不鍍膜的非導電性樣品能夠分析,但由于LVSEM樣品室中,電子束的通路上有殘余氣體分子存在,入射電子束會被散射開來,分析區域將變得很大,這也是值得注意的。
熱門資訊 
最新資訊 
- 觸發器失效分析,華南檢測精準 “把脈” 電子元件 | 華南檢測
- 水性產品測試分析服務,專業解決方案提供商 | 華南檢測
- 材料拉伸性能測試,助力工業產品質量提升
- 工業 CT 檢測,讓工業部件缺陷無處遁形
- 觸發器失效之謎:深度解析原因、影響與專業解決方案
- 環境可靠性測試哪家好?華南檢測為您揭秘產品品質提升秘籍
- 瓷片電容失效分析:從裂紋到擊穿,第三方檢測機構的解決方案
- 碳鋼棒異常斷裂案例分析
- PCB失效分析:深度解析潤濕不良、爆板、分層與CAF問題
- MLCC電應力擊穿失效分析:深度解析與可靠性提升方案
- 螺釘斷裂原因深度剖析與預防全解析(華南檢測案例)
- PCB焊接不良的原因及解決辦法全解析
- 機械沖擊試驗全解析:如何提升產品抗沖擊能力?| 華南檢測權威指南
- 工業CT掃描如何幫企業年省百萬?0.5μm精度+CMA/CNAS資質,華南檢測助企業降本50%
- 0.5μm誤差毀百萬訂單?鍍層厚度檢測標準與方法全解析
- 華南檢測:PCB切片分析專家,15年護航電子制造品質,助力企業年省千萬級質量成本
- PCB切片檢測:精準診斷電路板質量的核心技術
- 掃描電鏡分析:微觀世界的精準解碼與工業難題的終極方案
- 金屬成分檢測全解析:從技術手段到行業應用,助力制造業質量升級
- 連接器可靠性測試全解析:確保電子設備穩定運行的關鍵驗證






